Технологии нанесения оптических тонких пленок и вакуумного напыления
2026-01-23
В области оптических тонких пленок и вакуумных покрытий обычно используются технологии физического осаждения из паровой фазы (PVD). К PVD относятся такие методы, как термическое испарение, распыление (sputtering) и ионное осаждение (ion plating).
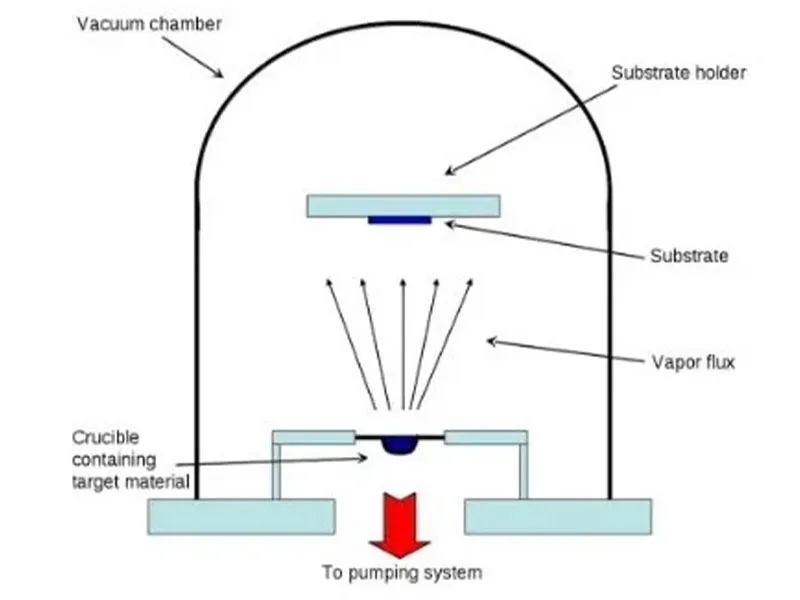
1. Термическое испарение (Thermal Evaporation)
Суть процесса: При нагревании испаряемого материала в вакуумной камере его атомы или молекулы покидают поверхность.
(1) Давление насыщенного пара
При определенной температуре давление, которое оказывает пар испаряющегося материала в вакуумной камере в процессе достижения равновесия с твердым или жидким веществом, называется давлением насыщенного пара Pv при этой температуре.
Зависимость давления пара материала от температуры выражается уравнением:
lgPv=A-B/T — соотношение между давлением пара и температурой испаряющегося материала.
A = C/2,3 B = ΔH/2,3R Значения A и B можно определить экспериментально.
ΔH = 19,12 Б (джоулей/моль)
Исходя из кривых давления насыщенного пара различных элементов, можно определить:
Температура, необходимая для достижения нормальной скорости испарения тонкой пленки, то есть температура, при которой давление насыщенного пара составляет 1 Па;
Чувствительность скорости испарения к изменению температуры.
Характер испарения: если температура испарения выше точки плавления, происходит испарение из расплава, в противном случае — сублимация.
Для однородной смеси двух или более веществ при испарении действуют следующие законы:
Полное давление паров PT смеси равно сумме парциальных давлений паров каждого компонента, т.е. PT = P1 + P2 + ... + Pi
Закон Урала: Если компонент i существует в чистом виде, пусть его давление насыщенного пара при данной температуре равно Pi. Если молярная доля компонента i в смеси равна Ni, а давление насыщенного пара компонента i в смеси равно Pi, то Pi = Ni × Pi. Скорость и энергия испарившихся частиц: Скорость √ύ² = √(3kt/m) = √(3RT/M) Энергия Ě = 3/2kT В диапазоне температур испарения 1000–2500℃ средняя скорость испарившихся частиц составляет приблизительно 10⁵ см·с⁻¹, что соответствует средней кинетической энергии приблизительно 0,1–0,2 эВ, т.е. 1,6×10⁻²⁰–3,2×10⁻²⁰ Дж.
(2) Резистивное испарение (Resistive Heating Evaporation)
a. Выбор материала испарителя (лодочки/тигля):
Точка плавления и давление пара: Нагреватель должен быть изготовлен из тугоплавкого материала. Необходимо учитывать количество материала испарителя, попадающего в пленку в качестве примеси.
Таблица: Характеристики материалов испарителей
| Материал | Точка плавления (°C) | Температура при давлении пара (Торр) | ||
| $10^{-8}$ | $10^{-5}$ | $10^{-2}$ (Темп. испарения) | ||
| Графит (C) | 3700 | 1800 | 2126 | 2680 |
| Вольфрам (W) | 3410 | 2117 | 2567 | 3227 |
| Тантал (Ta) | 2996 | 1957 | 2407 | 3057 |
| Молибден (Mo) | 2617 | 1592 | 1957 | 2527 |
| Ниобий (Nb) | 2468 | 1762 | 2127 | 2657 |
| Платина (Pt) | 1772 | 1292 | 1612 | 1907 |
(3) Реакция материала испарителя с материалом пленки:
CeO2 реагирует с Mo, Ta, W; следует использовать Pt лодочку.
Для Ge использовать графитовый тигель или Ta лодочку с вкладышем из графитовой бумаги.
W и Mo могут реагировать с H2O или кислородом.
Некоторые металлы образуют сплавы с материалом испарителя, что приводит к перегоранию (например, Ta и Au, Al и W, Ni и W при высоких температурах).
Смачиваемость: При использовании вольфрамовых проволочных испарителей материал пленки должен смачивать испаритель.
Типы резистивных испарителей:
A. Проволочные: Диаметр проволоки 0.5–1.0 мм, часто многожильные (3 жилы). Спиральные применяются для Al, Ni; конические корзинки — для кусковых/проволочных сублимирующихся материалов или несмачивающих материалов.
B. Фольговые (Лодочки): Толщина 0.05–0.15 мм. Большая площадь испарения. Важен хороший тепловой контакт с материалом во избежание локального перегрева и разбрызгивания (“плевков”).
C. Радиационные: Нагрев материала излучением вольфрамовой спирали (для легкоплавких материалов).
D. Тигельные (типа “Дымоход”): Похожи на радиационные, обеспечивают стабильное испарение.
E. “Взрывные” (Flash Evaporation): Непрерывная подача мелких частиц сплава/соединения на перегретый испаритель для мгновенного испарения и предотвращения фракционирования.
F. Графитовые: Для Ge, Ag, Ta и др. Используется спектрально чистый графит с гладкой поверхностью. Требует предварительной кислотно-щелочной очистки и прокаливания в вакууме (~2000 °C) для удаления S, P.
(4) Электронно-лучевое испарение (E-beam Evaporation)
Принцип: Электроны, эмиттируемые нитью накала, ускоряются высоким напряжением и фокусируются на поверхности материала. Кинетическая энергия преобразуется в тепловую, вызывая испарение.
(5) Лазерное испарение
Использование мощного лазера как источника тепла. Лазерный луч вводится через окно вакуумной камеры и фокусируется до плотности мощности $>10^6$ Вт/см².
Преимущества: Испарение тугоплавких материалов; бесконтактный нагрев (источник вне камеры) снижает загрязнение; подходит для сверхвысокого вакуума и получения чистых пленок; высокая скорость испарения.
Недостатки: Высокая стоимость; не для всех материалов дает преимущества.
(6) Реактивное испарение
Испарение металла или низковалентного соединения в среде реактивного газа для получения пленки соединения высшей валентности в процессе осаждения. Применяется, когда материал разлагается при прямом испарении или имеет слишком низкое давление пара. Степень реакции зависит от химических свойств, стабильности газа, свободной энергии образования соединения, температуры подложки и диссоциации.
2. Распыление (Sputtering)
(1) Основной принцип:
Ионы бомбардируют мишень, передавая импульс атомам. Если переданная энергия превышает теплоту сублимации, атом выбивается из решетки.
(2) Порог и коэффициент распыления:
Порог распыления: Минимальная энергия иона для начала распыления. Зависит от материала мишени, уменьшается с ростом атомного номера.
Коэффициент распыления: Среднее число выбитых атомов на один падающий ион. Зависит от типа, энергии и угла падения иона, а также типа, структуры и состояния поверхности мишени.
(3) Скорость и энергия частиц:
При бомбардировке ионами He+ большинство распыленных атомов имеют скорость 4 × 10⁵ см/с и среднюю кинетическую энергию 4,5 эВ; при бомбардировке ионами Ar+ большинство атомов металла имеют среднюю скорость 3–6 × 10⁵ см/с, а энергия частиц линейно возрастает с увеличением массы материала мишени.
(4) ВЧ-распыление (RF Sputtering):
Использование переменного ВЧ-поля позволяет бомбардировать мишень поочередно ионами и электронами. Пригодно для диэлектриков. Включение конденсатора позволяет распылять металлы.
(5) Магнетронное распыление:
Использование скрещенных электрического и магнитного полей заставляет электроны двигаться по циклоиде, увеличивая вероятность ионизации газа.
Преимущества: Высокая скорость распыления; «холодный» процесс для подложки (мало вторичных электронов); работа на DC и RF (металлы и диэлектрики).
Недостатки: Невозможность (в стандартном виде) распылять ферромагнетики при низких температурах; нагрев подложки от диэлектрической мишени; низкий коэффициент использования мишени (зоны эрозии, ~30%).
(6) Реактивное распыление:
Распыление в присутствии реактивного газа. Реакция идет на подложке и на поверхности мишени. Возможен переход мишени в «отравленный» режим (покрытие соединениями), что снижает скорость распыления (гистерезис процесса). Удобно для получения оксидов Ti, Ta, Zn, Sn.
3. Ионное осаждение (Ion Plating)
Гибридный метод, сочетающий вакуумное испарение и распыление.
Ионное осаждение на постоянном токе (DC Ion Plating): Материал испаряется резистивно. Между испарителем и подложкой (катод, 1–5 кВ) создается тлеющий разряд в Ar (1 Па). Испаряемые атомы ионизируются при пролете через плазму и ускоряются к подложке. Высокая энергия частиц (1–100 эВ) нагревает подложку и вызывает вторичное распыление уже осажденной пленки (очистка). Скорость осаждения должна превышать скорость распыления.
ВЧ ионное осаждение (RF Ion Plating): Добавление ВЧ-катушки повышает степень ионизации, позволяя работать при более низком давлении ($10^{-1} \sim 10^{-2}$ Па) и напряжении.
Метод кластерного ионного пучка (ICB): Пары материала выбрасываются через сопло тигля под давлением, образуя кластеры, которые затем ионизируются и ускоряются.
Преимущества ионного осаждения:
Высокая адгезия: Бомбардировка очищает подложку, удаляет слабосвязанные атомы, создает переходный слой (имплантация/диффузия).
Высокая плотность: Энергичные частицы и вторичное распыление уплотняют пленку, устраняя теневые эффекты. Плотность близка к объемному материалу.
Хорошая равномерность: Осаждение идет по силовым линиям поля, покрывая сложные формы и обратные стороны (“обволакивание”). Рассеяние в газе улучшает равномерность.
Высокая скорость осаждения.
Применение: Износостойкие покрытия (инструмент), твердые смазки, декоративные покрытия, а также высокопрочные и низкопотерьные (LVR) оптические покрытия (особенно низковольтное реактивное ионное осаждение).
















